
硅通孔 (TSV) 和玻璃通孔 (TGV) 中的填充电镀

In-Wafer Via Embedding Plating 技术以改善频率特性、高密度小型化和省电为目的,也被考虑用于 5G 通信应用。
本公司可对底孔(盲孔)和贯通孔进行电镀埋入金属。
主功能
低电阻 高导热性 高导电性低 导热性
尺寸:4inch to 8inch 晶圆
材质:Si、SiC、玻璃等
电解铜 |
高频特性、更高密度、更小体积、更低功耗 |
电解镍 |
高密度、小型化 |
*如需上述以外的规格,请随时与我们联系。

嵌入电镀横截面
TSV(Through Si Via)和TGV(Through Glass Via)在形成3D封装封装时连接上下芯片,通过集成实现更高的性能。我们可以为过孔内部提供电镀。我们专有的电镀方法可实现无空隙嵌入电镀。不仅可以在硅晶圆和玻璃晶圆上进行电镀,还可以在陶瓷基板和树脂基板上的通孔上进行电镀。
在以往的电镀方法中,需要通过CMP研磨进行通孔填充电镀,去除附着在正反面的镀层。
然而,通过使用我们独特的电镀方法,可以控制沉积在正反面的电镀膜量,从而可以显着缩短 CMP 抛光过程所需的时间。
常规)需要对晶圆正反面进行CMP抛光 |
目前)仅在晶圆表面通过CMP抛光完成! |
|
|
不同的过孔形成方法会导致不同的过孔形状。根据通孔的形状,嵌入电镀的质量可能存在差异。我们还支持各种过孔形状,例如直形、收缩形、锥形、不均匀壁形等。请联系我们了解金属类型。

可用通孔形状的横截面示意图
我们的非破坏性分析技术有助于提高可靠性并减少评估周期和样本量。
X-ray CT设备可以无损检测过孔内部的填充情况。样品尺寸最大可达芯片尺寸的 300 平方毫米。我们还可以评估激光显微镜和横截面。
|
|
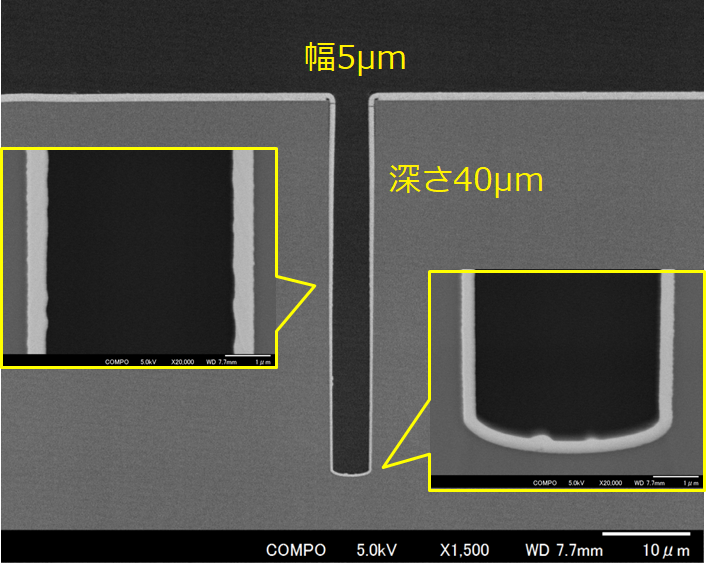
盲孔共形电镀横截面SEM纵横比:8(孔径5μm,深度40μm